
ВІННИЦЬКИЙ НАЦІОНАЛЬНИЙ ТЕХНІЧНИЙ УНІВЕРСИТЕТ
Факультет інфокомунікацій, радіоелектроніки та наносистем
Кафедра електроніки та наносистем
КУРСОВА РОБОТА
з дисципліни «Фізика напівпровідників»
на тему:
«Розрахунок основних параметрів в напівпровідниках з різним типом провідності»
студента 2 курсу групи МНТ-19б
напряму підготовки -171 «Електроніка»
Муравського О.О.
Керівник: к.т.н., доцент Мартинюк В. В.
Національна шкала _____________________
Кількість балів: _____ Оцінка: ECTS_____
Члени комісії
____________ _________________________
(підпис) (прізвище та ініціали)
____________ _________________________
(підпис) (прізвище та ініціали)
Вінниця 2021
ВІННИЦЬКИЙ НАЦІОНАЛЬНИЙ ТЕХНІЧНИЙ УНІВЕРСИТЕТ
ЗАТВЕРДЖУЮ
Зав. Кафедри електроніки та наносистем
__________ Й.Й.Білинський
9 вересня 2020р.
ІНДИВІДУАЛЬНЕ ЗАВДАННЯ
на курсову роботу
з дисципліни «Фізика напівпровідників»
студента 2-го курсу гр. ЕЛ-19б Муравського О.О.
на тему: «Розрахунок основних параметрів в напівпровідниках з різним типом провідності»
Розглянути основні параметри напівпровідників з різними типами провідності.
Розрахувати концентрацію основних, неосновних та власних носіїв заряду.
Розрахувати питому електропровідність, ЕРС Холла і рухливість електронів в зразку
Основні вхідні дані до завдання 2:ширина забороненої зони дорівнює 1,5 еВ, відносна ефективна маса електронів дорівнює 0,25, а дірок – 0,6. Рухливість основних носіїв заряду дорівнює 0,1 м2/В*с. Діапазон температур від 300К до 500К (крок вимірювання 50К).
Основні вхідні дані до завдання 3:прямокутний зразок напівпровідника n-типу х розмірами 5051 мм поміщений у магнітне поле. Вектор магнітної індукції перпендикулярний до площини зразка. Під дією повздовзньої напруги 0,42 В по ньому протікає струм 20 мА, ЕРС Холла складає 6.25В. Діапазон зміни магнітної індукції 0.5 – 1 Тл (крок вимірювання 01 Тл)
Дата попереднього захисту роботи 5 січня 2021р.
Завдання видав:
Керівник КР____________ Мартинюк В.В., к.т.н., доцент кафедри електроніки
14 вересня 2020р.
Завдання отримав:
студент_____________ Муравський О.О
14 вересня 2020
АНОТАЦІЯ
В даній курсовій роботі проведено аналіз напівпровідників різних типів провідності, а саме n- та p-типів. Розглянуто їх основні фізичні властивості та подано їх фізичну модель, на основі якої було проведено подальші розрахунки.
ЗМІСТ
ВСТУП …………………………………………………………………………... 4
РОЗДІЛ 1. АНАЛІЗ НАПІВПРОВІДНИКІВ p- та n- ТИПІВ ……….....…..…. 5
Домішки в кристалічній гратці напівпровідників …………………...……. 5
Напівпровідники р-типу …………………………….……………………… 6
Напівпровідники n-типу ……………………………………………………. 7
РОЗДІЛ 2. ФІЗИЧНІ ОСНОВИ ДОМІШКОВИХ НАПІВПРОВІДНИКІВ … 10
2.1 Енергетичний спектр і концентрація електронів у напівпровіднику...…. 10
2.2 Рухливість носіїв заряду в напівпровідниках ………………………..…... 12
2.3 Температурна залежність питомої електропровідності …….………….... 13
РОЗДІЛ 3. РОЗРАХУНОК ПАРАМЕТРІВ ДОМІШКОВИХ НАПІВПРОВІДНИКІВ НА ОСНОВІ ФІЗИЧНОЇ МОДЕЛІ….…...………... 15
3.1 Визначення концентрації носів заряду в домішковому напівпровіднику………………………………………………………………….15
3.2 Обчислення питомої електропровідності та рухливості носіїв струму у домішковому напівпровіднику …………………………………………...…… 17
ВИСНОВКИ ……..…………….……………………………………………….. 19
ВИКОРИСТАНА ЛІТЕРАТУРА ….……………………..…………….……… 20
ВСТУП
Актуальність роботи. Електротехніка та радіотехніка потребують для свого розвитку якісні матеріали, причому в більшості випадків ставлять до них найвищі вимоги. Одним з методів покращення напівпровідникових матеріалів в електротехніці та радіотехніці є додавання домішок. Домішкові напівпровідники відрізняються своїми параметрами від звичайних напівпровідників. Їх застосування значно покращує параметри електричних пристроїв.(5)
Швидке зростання виробництва та підвищення надійності виробів електронної техніки залежать не тільки від методів їх виготовлення, а й в значній мірі від електрофізичних і хімічних властивостей використовуваних матеріалів, які в свою чергу в багатьох випадках визначають параметри напівпровідникових приладів і інтегральних мікросхем, цим самим впливаючи на стабільність роботи в електричних та теплових режимах, а також при їх тривалому зберіганні.(4)
Мета: розрахувати основні параметри напівпровідників з різними типами провідності.
Структура: курсова робота складається з трьох розділів. У першому розділі проведено аналіз теоретичних даних про домішкові напівпровідники. В другому розділі подані фізичні основи напівпровідників з різними типами провідності. У третьому розділі були проведені розрахунки на основі фізичної моделі домішкових напівпровідників.
1 АНАЛІЗ НАПІВПРОВІДНИКІВ Р- ТА N-ТИПІВ
1.1 Домішки в кристалічній гратці напівпровідників
Реальні кристали завжди містять у своїй структурі дефекти. Дефектом є відсутність атома у вузлі кристалічної гратки, наявність сторонніх атомів у вузлах чи міжвузлах, порушення періодичності кристалічної гратки – так звані дислокації тощо
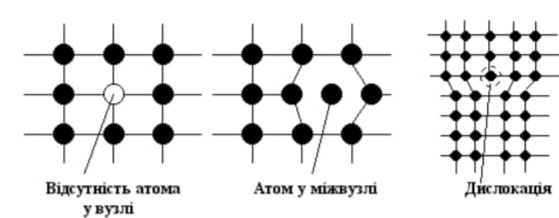
Рисунок 1 - Дефекти кристалічної гратки
Сторонні атоми в кристалі називаються домішками, а напівпровідники – домішковими. Саме домішкові напівпровідники широко використовуються при виготовленні різних приладів.
Домішки викликають локальні напруження в гратці, спотворюють поле гратки. Це призводить до виникнення в забороненій зоні напівпровідника локальних (дискретних) енергетичних рівнів, тому що концентрація домішок звичайно мала, так що їх атоми знаходяться на великих відстанях і не взаємодіють між собою. Домішки можуть бути донорного і акцепторного типів.
Розглянемо чотиривалентні германій (Ge) та кремній (Si) з домішками атомів, валентність яких відрізняється на одиницю, тобто 3 і 4 груп. Ge і Si мають гратку типу алмазу, в якій кожен атом зв’язаний ковалентними (парноелектронними) зв’язками з чотирма найближчими сусідами (Рис.2). Подвійними лініями позначені ковалентні електронні зв’язки.(2)
1.2 Напівпровідники р-типу
Якщо замість чотиривалентного атома Ge у вузлі гратки помістити п’ятивалентний атом фосфору P, то на утворення ковалентних зв’язків піде чотири електрони. П’ятий електрон не буде зв’язаний і він легко відривається від атома фосфору. Такий електрон стає вільним і може створювати струм. Атом фосфору при цьому заряджається додатньо, проте він залишається у вузлі і преміщуватися та створювати струм не може.

Рисунок 2 - Донорна домішка у кристалічній гратці Германію
Таким чином, в напівпровіднику з домішкою, валентність якої на одиницю більша, аніж валентність основних атомів, основними носіями є електрони. Тому кажуть, що даний напівпровідник має електронну провідність і є напівпровідником n-типу (negative). Атоми домішок, котрі дають електрони провідності, носять назву донори.
На енергетичній діаграмі вільні електрони дислокуються в зоні провідності. Це в свою чергу, означає, що домішкові рівні атомів, з яких електрони прейшли в зону провідності, дислокуються поблизу цієї зони в забороненій зоні. Вони зображаються штриховими лініями, так як домішок в напівпровіднику звичайно мало.
 Рисунок 3 - Енергетична діаграма з донорними домішками
Рисунок 3 - Енергетична діаграма з донорними домішкамиЕнергія необхідна для переведення електрона з домішкового рівня в зону провідності, називається енергією активації (Wд). Енергії активації донорних домішок Sb, P, As в кристалах Ge і Si наведені в ( Таб.1):
Таблиця 1 - Енергія активації донорних домішок Sb, P, As в кристалах Ge і Si
| | Sb, eB | P, eB | As, eB |
| Ge | 0.010 | 0.012 | 0.015 |
| Si | 0.039 | 0.044 | 0.049 |
Так як при Т = 300К кТ 0,03 еВ, то донорні рівні Ge і Si при кімнатній температурі всі іонізовані, а електрони з них перейшли в зону провідності. Рівень фермі в домішковому донорному напівпровіднику при низьких температурах знаходиться між зоною провідності і домішковим рівнем.(1)
1.3 Напівпровідники n-типу
Зараз розглянемо випадок , у якому валентність домішки на одиницю менша від валентності основних атомів. Нехай у вузлах гратки знаходяться атоми чотиривалентного Si з домішкою тривалентного бора (Рис.4).

Рисунок 4 - Акцепторна домішка в кристалічній гратці Силіцію
Бор може віддати для валентного зв’язку три електрони. Один зв’язок через це буде неукомплектованим і представлятиме з себе місце з недостачею електрона. В результаті теплового руху на це місце перейде електрон з сусіднього атома Si, а на залишеному сусідньому атомі утвориться дірка, яка буде хаотично рухатися по кристалу.
На місці атома домішки, на яке перейде електрон, утвориться від’ємний заряд. Але так як він зв’язаний з атомом і внаслідок цього не може стати носієм струму. Атому бору у вузлі стане від’ємнозарядженим іоном.
Отже, дірка – це відсутність електрона не на домішковому, а на власному атомі. Дірка може направлено рухатись під дією електричного поля, тому така провідність називається дірковою, а напівпровідник – дірковим і відноситься до p-типу (positive). Домішки, які викликають появу дірок, називаються акцепторами.
На енергетичній діаграмі акцепторні рівні розташовані поблизу валентної зони. На ці рівні надходять електрони з із валентної зони, тобто переходять з основних атомів на домішки, цим самим залишаючи дірки у валентній зоні (Рис.5):
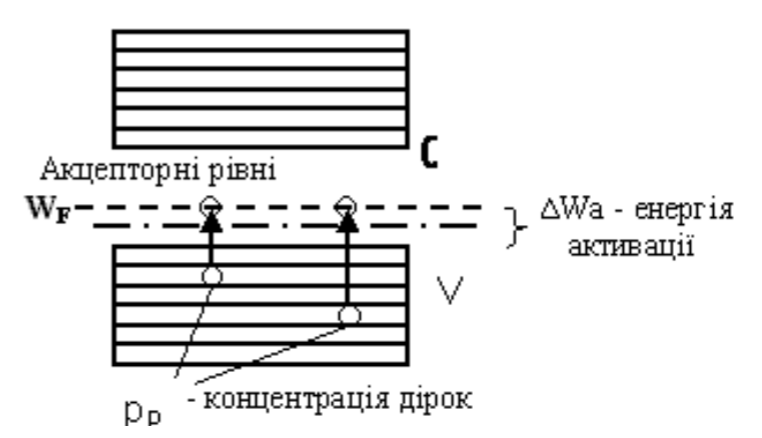
Рисунок 5 - Енергетична діаграма з акцепторними домішками
Рівень Фермі в дірковому напівпровіднику розташований між акцепторними рівнями та валентною зоною ( в залежності від температури його розташування змінюється).
Енергія активації домішок In і В в германії та кремнії наведена в (Таб 2):
Таблиця 2 - Енергія активації домішок In і В в германії та кремнії
| Ge | 0.011 | 0.010 |
| Si | 0.160 | 0.045 |
Таким чином, електропровідність домішкового напівпровідника визначається як і типом домішок, так і їх кількістю у ньому.
Розділ 2 ФІЗИЧНІ ОСНОВИ ДОМІШКОВИХ НАПІВПРОВІДНИКІВ
2.1 Енергетичний спектр і концентрація електронів у напівпровіднику
Енергетичний спектр електронів у напівпровідниках визначають на основі зонної теорії твердого тіла, яка виходить із розв’язку рівняння Шредінгера для системи частинок, які утворюють тверде тіло, з послідовним використанням адіабатичного й одноелектронного наближень, а також наближень сильного чи слабкого зв’язку валентних електронів з атомними залишками. Із цього витікає, що енергія електронів у твердому тілі може приймати дискретні значення в деяких дозволених областях значень (дозволених зонах). Граничні значення енергії в кожній дозволеній зоні є функціями хвильового вектора k. Залежність значень енергій, які відповідають краям дозволених зон, від хвильового вектора Е(k) характеризує структуру енергетичних зон напівпровідника.
При вивченні електричних, оптичних та теплових властивостей напівпровідників важливою є структура останньої заповненої (валентної) зони і першої вільної зони (зони провідності). Проміжок між найближчими краями цих дозволених зон називається енергетичною щілиною або забороненою зоною. Енергетичну відстань між мінімумом і максимумом валентної зони, навіть якщо вони (як це спостерігається в кремнії, германії та деяких інших напівпровідниках) припадають на різні значення хвильового вектора k, називають шириною забороненої зони; отже, вона визначається формулою:
 (2.1)
(2.1)Для того, щоб електрон із заповненої валентної зони міг перейти у вільну зону і опинитися в сімействі вільних електронів, йому потрібно передати енергію не меншу ніж
 . Така енергія з повною ймовірністю може бути передана електрону кристалічною граткою.
. Така енергія з повною ймовірністю може бути передана електрону кристалічною граткою.Імовірність того, що стан з енергією Е у вільній зоні напівпровідника буде зайнятий електроном, визначається функцією розподілу Фермі-Дірака:
 (2.2)
(2.2)де ЕF – енергія Фермі;
kB =
 – стала Больцмана;
– стала Больцмана;Т – температура зразка.
Якщо показник експоненти
 , то
, то  , тобто заповнення станів у вільній зоні визначається функцією Максвела – Больцмана (невироджений напівпровідник). Це означає що концентраціяn вільних електронів, згідно з формулою:
, тобто заповнення станів у вільній зоні визначається функцією Максвела – Больцмана (невироджений напівпровідник). Це означає що концентраціяn вільних електронів, згідно з формулою: (2.3)
(2.3)залежить від температури і при її зростанні має збільшуватись. У формулі (1.3) g(E) – густина енергетичних станів в інтервалі від Е до E+dE. Інтегрування в рівнянні (1.3) ведеться у всьому інтервалі енергій вільної зони і у випадку невиродженого напівпровідника приводить до виразу:
 (2.4)
(2.4)де m*dn – ефективна маса густини станів електронів у зоні провідності;
Nc – ефективна густина станів поблизу дна вільної зони
h – стала Планка
Вираз для концентрації дірок має аналогічний вигляд як і рівняння для концентрації електронів:
 (2.5)
(2.5)де m*dp – ефективна маса густини станів дірок у валентній зоні;
Nv – ефективна густина станів поблизу стелі валентної зони.
У власному напівпровіднику концентрації електронів і дірок однакові – n=p:
 (2.6)
(2.6)тобто концентрація вільних носіїв заряду у власному напівпровіднику визначається шириною забороненої зони і температурою зразку.
У формулі (1.6) індекс і(intrinsic) означає «власний».
Введення домішкових атомів в напівпровідник спричиняє виникнення в забороненій зоні напівпровідника локальних енергетичних станів (домішкових рівнів). Якщо енергія іонізації нейтрального домішкового атома незначна, а сама іонізація пов’язана з переходом електрона у вільну зону, то домішку називають донорною, а якщо іонізація домішки пов’язана із захопленням електрона з валентної зони, то домішку називають акцепторною. При введенні донорної домішки в напівпровідник збільшується концентрація електронів у вільній зоні і зменшується концентрація дірок, оскільки останні тепер будуть значно частіше рекомбінувати з електронами. Якщо ж ввести акцепторну домішку, то навпаки – підвищиться концентрація дірок у валентній зоні і в стільки ж разів зменшиться концентрація вільних електронів у зоні провідності.
У домішкових напівпровідників носії заряду поділяються на основні – ті, яких більша кількість, та неосновні – ті, кількість яких менша. Окрім цього, носії заряду поділяються на рівноважні – ті, які утворенні внаслідок термічної іонізації, та нерівноважні– ті, які утворенні за рахунок будь-якого іншого джерела енергії, наприклад, світла, електричного поля, електромагнітного опромінення тощо. Нерівноважні носії заряду також називають надмірними. Вони зникають як тільки перестає діяти фактор, який спричинив їх появу.
Співвідношення між концентраціями основних і неосновних носіїв заряду в домішковому напівпровіднику визначається законом діючих мас і для донорного напівпровідника (n-типу) має вигляд:
 (2.7)
(2.7)Для акцепторного напівпровідника (р-типу) формула має аналогічний вигляд:
 (2.8)
(2.8)Концентрація основних носіїв заряду залежить від енергії іонізації домішок (Ed – для донорної та Еа – для акцепторної), концентрації домішок (Nd чи Na) та температури напівпровідника.
2.2 РУХЛИВІСТЬ НОСІЇВ ЗАРЯДУ В НАПІВПРОВІДНИКАХ
У вакуумі вільний носій заряду рухається прискорено, а в кристалі він дуже часто стикається з різними дефектами структури, при цьому він втрачає частину своєї енергії та змінює напрям руху. Тому в кристалі під дією поля електрон рухається з деякою середньою швидкістю V. відношення його середньої швидкості V до напруженості поля називають рухливістю носія заряду:
 (2.9)
(2.9)Рухливість має розмірність м2/В*с і характеризує «схильність» носія заряду до руху. Центрами розсіювання для вільних носіїв заряду можуть виступати як теплові коливання кристалічної гратки так і статичні дефекти в структурі кристала: нейтральні атоми та іони домішок, вакансії атомів, атоми у міжвузловинах, дислокації тощо.
2.3 Температурна залежність питомої електропровідності
Повна питома провідність напівпровідника має дві складові: електронну та діркову:
 (2.10)
(2.10)де, - питома електропровідність;
е – заряд електрона.
У цій формулі від температури залежать концентрації й рухливість носії заряду. Оскільки рухливість, яка має степеневу залежність від температури, менш чутлива до зміни температури, ніж концентрація носіїв заряду, яка має експоненціальну залежність від температури, то температурна залежність питомої електропровідності може бути представлена формулою:
 (2.11)
(2.11)де, 0 – слабко залежна від температури функція, яка відповідає значенню при Т=;
Еа – енергія активації провідності.
В області низьких температур (Т Тs) Еа дорівнює енергії іонізації домішки:
 – для донорної домішки (2.12)
– для донорної домішки (2.12) – для акцепторної домішки (2.13)
– для акцепторної домішки (2.13)В області середніх температур (Тs T Ti) формула (1.11) не діє, оскільки у цьому інтервалі температур концентрацію основних носіїв заряду можна вважати незмінною (n = Nd – для донорної домішки або p = Na – для акцепторної домішки). То характер температурної залежності визначає залежність рухливості носіїв заряду від температури, а вона в області вище 0 оС, як правило, спадає із збільшенням температури.
3 РОЗРАХУНОК ПАРАМЕТРІВ ДОМІШКОВИХ НАПІВПРОВІДНИКІВ НА ОСНОВІ ФІЗИЧНОЇ МОДЕЛІ
3.1 Визначення концентрації носів заряду в домішковому напівпровіднику
Концентрація носіїв заряду залежить від температури й від таких характеристик напівпровідника, як ширина забороненої зони й ефективні густині станів у зоні провідності й валентній зоні.
Будемо вважати, що у напівпровідника явно виражена домішкова провідність (про це нам говорить низький питомий опір). Тоді для питомого опору можемо записати формулу:
 (3.1)
(3.1)де е – заряд електрона,
nn – концентрація основних електронів,
n – рухливість електронів.
З формули (3.1) ми отримаємо:
 (3.2)
(3.2)Підставимо числові значення у формулу (3.2) і отримаємо концентрацію основних носіїв заряду:

Формула для обчислення концентрації власних носіїв струму:
 (3.3)
(3.3)де mn, mp – ефективна маса електронів та дірок відповідно,
k – стала Больцмана у [Дж/К],
Т – температура,
h – стала Планка у [Дж*с],
Еg – ширина забороненої зони у [Ев].
Підставимо дані нам числові значення в формулу (3.3) і отримаємо наступний результат:

Аналогічно підставимо значення температур в діапазоні від 300К до 500К з кроком в 50К і отримаємо наступні значення:
n2 = 1.492 * 1020(м-3)
n3 = 18.23 * 1020(м-3)
n4 = 2.175* 1020(м-3)
n5 = 2.547 * 1020(м-3)
Отримавши дані результати, ми можемо скласти графік залежності власних носів заряду від температури:
 Рисунок 6 - Графік залежності власних носів заряду від температури
Рисунок 6 - Графік залежності власних носів заряду від температуриЯк видно з графіка, концентрація основних носів заряду зростає зі збільшенням температури.
Нам відомо, що
 (3.4)
(3.4)де рn – концентрація неосновних дірок в n-області. Звідси отримуємо:
 (3.5)
(3.5)Підставимо дані нам числові значення у формулу (3.5) і отримаємо наступний результат:

Аналогічно підставимо значення температур в діапазоні від 300К до 500К з кроком в 50К і отримаємо наступні значення:
pn2 = 1.07 * 1019(м-3)
pn3 = 1.6 * 1019(м-3)
pn4 = 2.275 * 1019(м-3)
pn5 = 3.12 * 1019(м-3)
Отримавши дані результати, ми можемо скласти графік залежності не основних носів заряду від температури:

Рисунок 7 – Графік залежності неосновних носів заряду від температури
Як видно з даного графіка, концентрація неосновних носів заряду збільшується зі зростанням температури.
Розрахувавши всі величини ми отримали такі результати:
Концентрація основних носіїв заряду становить: nn = 2.08 * 1021(м-3);
Концентрація власних носіїв заряду в діапазоні температур від 300К до 500К з кроком в 50К дорівнює: n1 = 1.184 * 1020(м-3),
n2 = 1.492 * 1020(м-3), n3 = 18.23 * 1020(м-3), n4 = 2.175* 1020(м-3),
n5 = 2.547 * 1020(м-3);
Концентрація неосновних носіїв заряду в діапазоні температур від 300К до 500К з кроком в 50К дорівнює: pn1 = 6.74 * 1018(м-3),
pn2 = 1.07 * 1019(м-3), pn3 = 1.6 * 1019(м-3), pn4 = 2.275 * 1019(м-3),
pn5 = 3.12 * 1019(м-3).
3.2 Обчислення питомої електропровідності та рухливості носіїв струму у домішковому напівпровіднику
Питома провідність — це обернений опір електричного опору. Вона являє собою здатність матеріалу проводити електричний струм.
Питомий опір напівпровідника обчислюється за формулою:
 (3.7)
(3.7)де l – довжина напівпровідника,
h– висота напівпровідника,
b– товщина напівпровідника (найменший розмір).
За законом Ома опір зразка буде обчислюватися за формулою:
 (3.8)
(3.8)де U – повздовжня напруга,
I– сила струму, який проходить через зразок.
Питома електропровідність зразка обчислюється за формулою:
 (3.9)
(3.9)Підставимо дані нам числові дані в формулу (3.9) і отримаємо значення питомої електропровідності зразка:

Формула для обчислення ЕРС Холла:
 (3.10)
(3.10)звідси отримаємо формулу для обрахунку концентрації електронів:
 (3.11)
(3.11)підставивши числові данні у формулу (3.11) отримаємо:

Аналогічно підставимо значення магнітної індукції в діапазоні від 0.5Тл до 1Тл з кроком в 0.1Тл і отримаємо наступні результати:
n2 = 1.2 * 1022 (м-3)
n3 = 1.4 * 1022 (м-3)
n4 = 1.6 * 1022 (м-3)
n5 = 1.8 * 1022 (м-3)
n6 = 2 * 1022 (м-3)
Отримавши ці результати, можемо скласти графік залежності концентрації носіїв заряду від магнітної індукції:

Рисунок 8 – Графік залежності концентрації носіїв заряду від магнітної індукції
Як видно з графіка, чим більше магнітна індукція діє на зразок, тим більша концентрація носів заряду наявна в ньому.
Рухливість електронів обчислимо використовуючи формулу:
 (3.12)
(3.12)Підставимо в формулу (3.12) числові значення величин і проведемо обчислення:

Розрахувавши всі величини ми отримали отримали наступні значення:
Питома електропровідність зразка: 𝛾 = 476(Ом-1*м-1);
Концентрація електронів в зразку в діапазоні магнітної індукції від 0.5Тл до 1Тл з кроком в 0.1Тл: n1 = 10 * 1021 (м-3), n2 = 1.2 * 1022 (м-3),
n3 = 1.4 * 1022 (м-3), n4 = 1.6 * 1022 (м-3), n5 = 1.8 * 1022 (м-3),
n6 = 2 * 1022 (м-3)
Рухливість електронів в зразку - n = 0.298 (м2/В*с)
ВИСНОВКИ
У роботі було розглянуто поділ домішкових напівпровідників на домішкові напівпровідники n-типу та p-типу.
Проаналізовано основні параметри домішкових напівпровідників.
Подано фізичну модель домішкових напівпровідників і на її основі проведено розрахунки.
Розраховано концентрації власних, основних та неосновних носів заряду від температури в домішковому напівпровіднику і отримано наступні результати:
концентрація основних носіїв заряду становить: nn = 2.08 * 1021(м-3);
концентрація власних носіїв заряду в діапазоні температур від 300К до 500К з кроком в 50К дорівнює: n1 = 1.184 * 1020(м-3),
n2 = 1.492 * 1020(м-3), n3 = 18.23 * 1020(м-3), n4 = 2.175* 1020(м-3),
n5 = 2.547 * 1020(м-3);
концентрація неосновних носіїв заряду в діапазоні температур від 300К до 500К з кроком в 50К дорівнює: pn1 = 6.74 * 1018(м-3),
pn2 = 1.07 * 1019(м-3), pn3 = 1.6 * 1019(м-3), pn4 = 2.275 * 1019(м-3),
pn5 = 3.12 * 1019(м-3).
Розраховано питому електропровідність, рухливість електронів та їх концентрацію, в результаті чого отримано наступні результати:
питома електропровідність зразка: 𝛾 = 476(Ом-1*м-1);
рухливість електронів зразка: n = 0.298 (м2/В*с);
концентрація електронів в зразку в діапазоні магнітної індукції від 0.5Тл до 1Тл з кроком в 0.1Тл: n1 = 10 * 1021 (м-3), n2 = 1.2 * 1022 (м-3),
n3 = 1.4 * 1022 (м-3), n4 = 1.6 * 1022 (м-3), n5 = 1.8 * 1022 (м-3),
n6 = 2 * 1022 (м-3).
ВИКОРИСТАНА ЛІТЕРАТУРА
Фізичне матеріалознавство. Частина IV. Напівпровідники: навчальний посібник / Поплавко Ю.М., В.І. Ільченко, Воронов С.А., Якименко Ю.І. - Київ: видавництво «Політехніка» Національного Технічного університету України, 2010. 352с.
Третяк О.В. Основи фізики напівпровідників: підручник : 2 т. / Третяк О.В., Лозовський В.З. – Київ : Видавничо-поліграфічний центр «Київський університет», 2007. 338с.
Царенко О.М. Основи фізики напівпровідників і напівпровідникових приладів: навчальний посібник. / Царенко О.М. – Кіровоград: РВВ КДПУ ім. В. Винниченка, 2011. 243с.
Закалик Л.І. Основи мікроелектроніки. / Закалик Л.І., Ткачук Р.А. Тернопіль: ТДТУ ім. І.Пулюя, 1998. 352с.
Курносов А.И. Материалы для полупроводниковых приборов и интегральных микросхем. / Курносов А.И. - Москва : Висшая школа, 1989. 327с.
Степаненко И.П. Основы микроэлектроники. / Степаненко И.П. – Москва : Советское радио, 1986. 424с.
Ефимов И.Е. Основы микроэлектроники. / Ефимов И.Е., Козырь И.Я. - Москва : Высшая школа, 1983. 384с.